新兴应用市场持续带动环氧塑封料市场的增长。先进封装元件的轻薄化、大功率、高集成度趋势对环氧塑封料的性能要求也越来越高。全球环氧塑封市场产品迭代更级也越来越快。中国拥有最广泛的EMC市场,外企凭借技术沉淀,结合中国客户需求,不断开发更为优质、实用的材料。中国企业也努力提升自身的研发和出货能力,持续与国际领先水平接轨。 EMC全球技术趋势与竞争格局 环氧塑封料主要壁垒是配方技术,来自各类复杂聚合物填料(环氧树脂、偶联剂、硬化剂、硅微粉、氧化铝等)和添加剂(脱模剂、染色剂、阻燃剂、应力添加剂、粘结剂等)的巧妙组合,根据用客户需求掌握配方品质和工艺控制,样品最终交付下游客户考核验证。一款高性能的先进封装材料,需要厂商长期的技术积累及持续的研发投入。 面向BGA、SCP、FOWLP、SiP等先进封装用环氧塑封料需要低翘曲、低膨胀、高填充和高导热的性能。2.5D/3D、FOWLP/FOPLP 以及系统级封装等先进封装需要更高流动性的GMC/LMC产品。AI带来了较大的HBM的需求,HBM需要散热性更高的 EMC 产品,为先进封装打开的新增长空间。 由于日本环氧塑封料厂商通过持续不断的研发准确反映市场趋势和用户愿望,掌握了完善的产品配方开发流程与大量核心知识产权专利,因此在高性能先进封装应用领域主要份额为日系企业所垄断,这些日企为:住友电木(Sumitomo Bakelite)、 Resonac(昭和电工与日立化成合并而成)、松下电工(Panasonic)、京瓷(Kyocera)、信越化学(ShinEtsu Chemical)、日东电工、东芝、长濑工(Nagase)等。另有韩国KCC、Samsung SDI、Nepes, 美国瀚森(Hexion)、台湾长兴工业 (Eternal Materials)和长春塑封料…… 这些外商品牌在中高端产品中占有较大份额,无论是在产能规模还是在产品结构上,拥有比中国大陆厂商更强劲、更广泛的全球合作竞争优势,其中几家全球知名的半导体材料制造商,在高端先进封装用环氧塑封材料放量更是处于完全垄断地位。 1950年代,陶瓷、金属、玻璃等封装难以适应半导体工业化的要求。于是乎,美国人开始研究塑料来代替昂贵的材料封装,到1962年塑料封装晶体管在工业上已初具规模。后来传到日本,日、美等公司不断精选原材料和生产工艺,最终完善了的环氧塑封料工艺,首次在航空航天工业中进行商业应用,此后迅速渗透到几乎所有工业领域。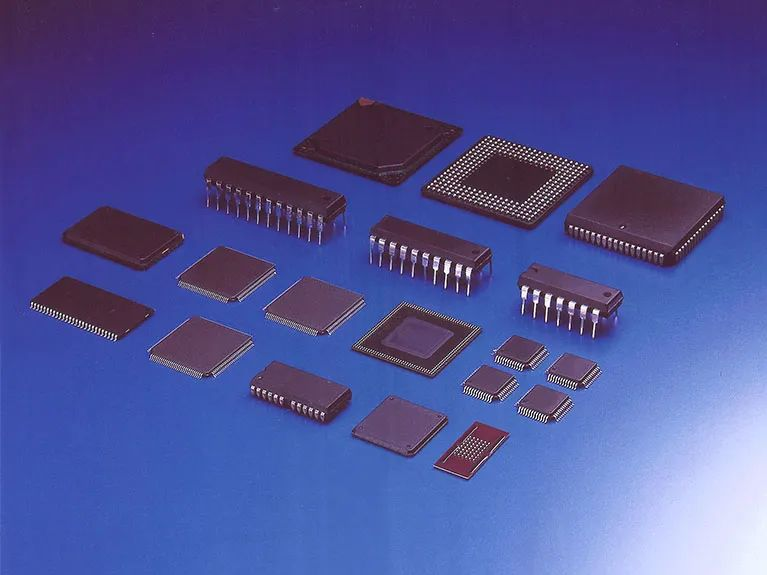
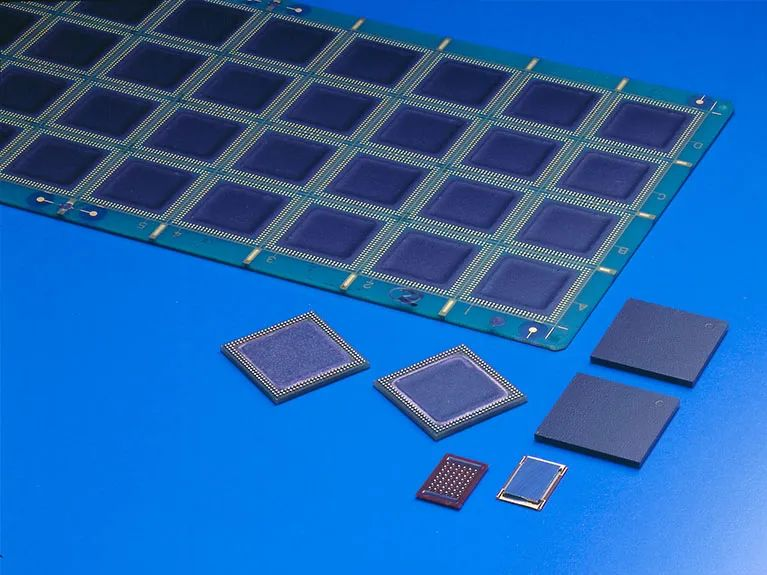 适用于BGA和CSP 图源:Resonac
适用于BGA和CSP 图源:Resonac

住友电木(Sumitomo Bakelite Co., Ltd.)是一家总部位于日本东京的化学工业公司,半导体材料是公司三大板块之一。住友电木目前拥有全球最大的环氧塑封料业务。用于半导体器件封装的环氧塑封料品牌——SUMIKON® EME 占据全球40%市场份额,来自中国的营收占比约为20%。在九州、新加坡、苏州、台湾设有生产工厂和研究所。
SUMIKON® EME为环保型产品,未使用溴系及锑系阻燃剂,阻燃试验标准UL-94的等级达到V-0。用于“大型电子模块(ECU)”、电机转子磁体固定、传感器模块、电源模块的保护、防湿、绝缘用途的封装。 SUMIKON® 系列 图源:住友电木
SUMIKON® 系列 图源:住友电木
住友电木看到在半导体市场,对远程工作外围设备、家用电器和数据中心应用、实现碳中和的可再生能源应用以及汽车(自动驾驶和电动汽车)和工业应用的需求不断增加。为了确保未来进一步扩大的中国市场作为可行的半导体封装材料的充足供应能力,计划投资约66亿日元在苏州工业园区获得土地并建设半导体封装用环氧模塑料生产建设项目并将在中国的产能扩大1.3次。新工厂占地约60,000 ㎡,计划于2023财年完成建筑和生产线的安装,并于2024财年初开始生产。项目建成后,年产半导体芯片封装用环氧模塑料33240吨、芯片贴片胶19.98 吨,研发芯片贴片胶和环氧模塑料。 住友电木(苏州)有限公司新工厂外观
住友电木(苏州)有限公司新工厂外观
力森诺科(Resonac Corporation)是半导体行业环氧模塑料的顶级供应商之一,2022年由昭和电工与日立化成合并而成,半导体及电子材料是公司四大板块业务之一。Resonac 拥有30多年的经验。代号为CEL系列产品可用在引线框架和基板。
引线框架用EMC来自昭和电工材料的环氧塑封料,具有卓越的连续作业性能卓越的耐湿性、耐热冲击性、耐回流焊性。支持DIP、SOP、TSOP、QFP 、TQFP、 LQFP等封装形式。 引线框架用EMC 图源:Resonac
引线框架用EMC 图源:Resonac
基板用环氧塑封料CEL系列同样来自昭和电工材料的环氧塑封料,具备可降低封装的翘曲、卓越的耐回流焊特性,可支持Flip chip的极小底部填充。支持的封装形式:CSP、BGA、Stacked MCP及其他。 引线框架用EMC 图源:Resonac
引线框架用EMC 图源:Resonac
随着汽车行业的不断发展,封装需要满足 AEC-Q100 Grade0 MSL1 标准及更高标准。Resonac 公司正在开发新的 EMC 来应对这一挑战——NH-860 系列。它采用低模量和高粘合强度设计,采用非粗糙化 QFN 封装,具有高效能、降低整体封装成本的良好潜力。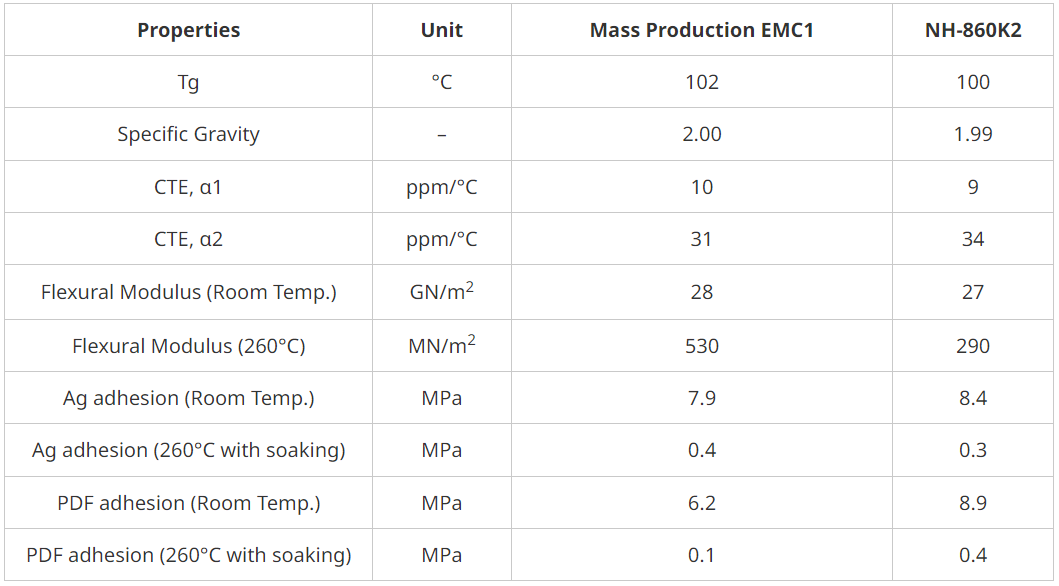 NH-860K2具有较低的模量和较高的粘合强度,可防止分层 图源:Resonac
NH-860K2具有较低的模量和较高的粘合强度,可防止分层 图源:Resonac
力森诺科苏州公司(原蔼司蒂电工材料苏州公司)是日立集团的成员之一,是环氧塑封行业的领先者,占大陆集成电路塑封料市场份额35%。2022年公司计划总投资5亿元,新购45亩工业用地用于扩建先进集成电路专用环氧塑封料及芯片贴片材料厂房,将填补未来5-10年集成电路行业对于环氧塑封需求的市场空缺。

苏州新工厂 图源:Resonac
三星SDI是三星集团在电子领域的附属企业。在1994年通过开发半导体密封剂EMC,迈出了进军电子材料业务领域的第一步。其Starem® 环氧模塑料 (EMC) 用于功率分立半导体封装。其主要成分为环氧树脂、硬化剂、二氧化硅及其他添加剂,提供多种无卤化合物的产品线:拥有提高组装成品率、低温固化和宽工艺的MUF EMC;控制Warpage的最佳解决方案、优秀叠层收率提高可靠性的PoP-t EMC;良好的可塑性和高覆盖性、优秀的颗粒尺寸控制的Granule EMC。应用包括存储器、系统LSI、单个设备等。  三星 SDI 停产产品名称
三星 SDI 停产产品名称
三星SDI在环氧模塑料业务中是一个相对较新的公司,于2014年Cheil Industries被三星SDI收购时从Cheil Industries收购了该业务。2000 年初,Cheil Industries 开始积极拓展其 EMC 业务,推广用于单一、超大容量离散应用的超低成本环氧模塑料。这些成熟产品通常是 TO220、TO247 和 TO92 封装用。但其价格比竞争对手低了60%之多。2018年8月,三星SDI宣布退出环氧模塑料业务。
化学和汽车零部件制造商KCC Corp是韩国第一家开发EMC的企业。公司在1985年开始开发KTMC,1992年商业化,是海力士、仙童半导体的供应伙伴。公司EMC产品——KTMC是一种非常高水平的环氧树脂封装材料,可以适用于极小的晶体管高速堆叠CPU需要高可靠性和可操作性。专门用于封装高密度存储设备和高压离散设备与KCC先进配方技术,用于TSOP、FCBGA、TKMC、SOIC、QFN/PLCC、DIP封装中。 图源:KCC
图源:KCC
KCC Corp在2023年正在扩大其半导体密封材料环氧模塑料 的安城工厂生产线,以加速进军芯片市场。新扩建工厂的 EMC 产能为 2,400 吨,加上该公司位于全罗北道全州的 8,000 吨产能,KCC已确保年产能超过 10,000 吨。安城工厂预计将主要生产用于电源、内存和系统半导体的高端 EMC 产品。
作为高科技材料的超级供应商,信越化学不断地提供着最尖端的技术和产品,在半导体封装材料领域,有移动成型用环氧树脂封装材料——KMC系列,以及元器件保护、粘结用液状环氧树脂的封装材料——SMC系列。
KMC系列是一种单组份型液态环氧材料,是采用先进技术开发出有机硅的环氧模塑料,特别适用于底部填充应用。KMC系列具有优异的低应力和低翘曲,以及高耐热性和高导热性。适用于BGA、SMD、SIP等各类的尖端半导体封装,KMC不仅为一般半导体器件,而且还为大型车载电源模块和各种传感器应用提供高度可靠的封装材料。
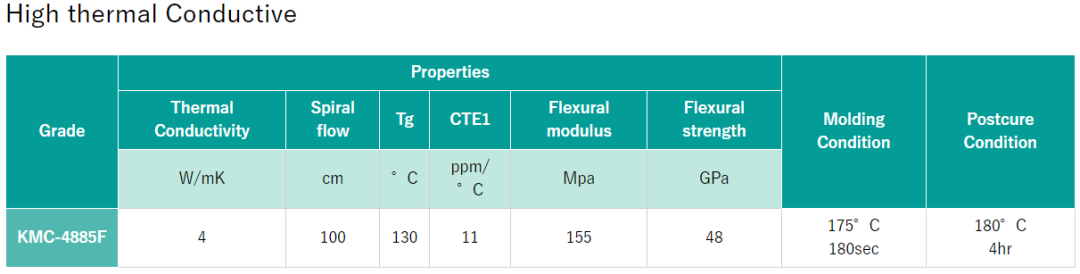

KMC系列部分特征 图源:ShinEtsu Chemical
液态环氧塑封料——SMC系列是为半导体器件的灌封材料、粘合剂和底部填充材料而开发的液态环氧封装材料。由该封装材料保护的半导体器件具有优异的电性能和防潮性。通过矽胶技术从低应力性来显示其超越的耐撞击性。此外,使用信越化学独创技术的有机硅所带来的低应力特性,在耐热性方面也表现出优异的特性。


SMC系列 图源:ShinEtsu Chemical
京瓷化学拥有超30年的半导体用环氧模塑料开发和制造经验,拥有福岛郡山工厂。京瓷化学新开发的环氧树脂和酚醛模塑料专为半导体封装高可靠性而设计。在BGA封装上使用的环氧树脂塑封材料方面,京瓷具备混合超细小(10μm以下)填充物的制备工艺,另外,在SiC、GaN等有高散热要求的封装产品上,京瓷也研发了有高导热性能的环氧树脂塑封料。
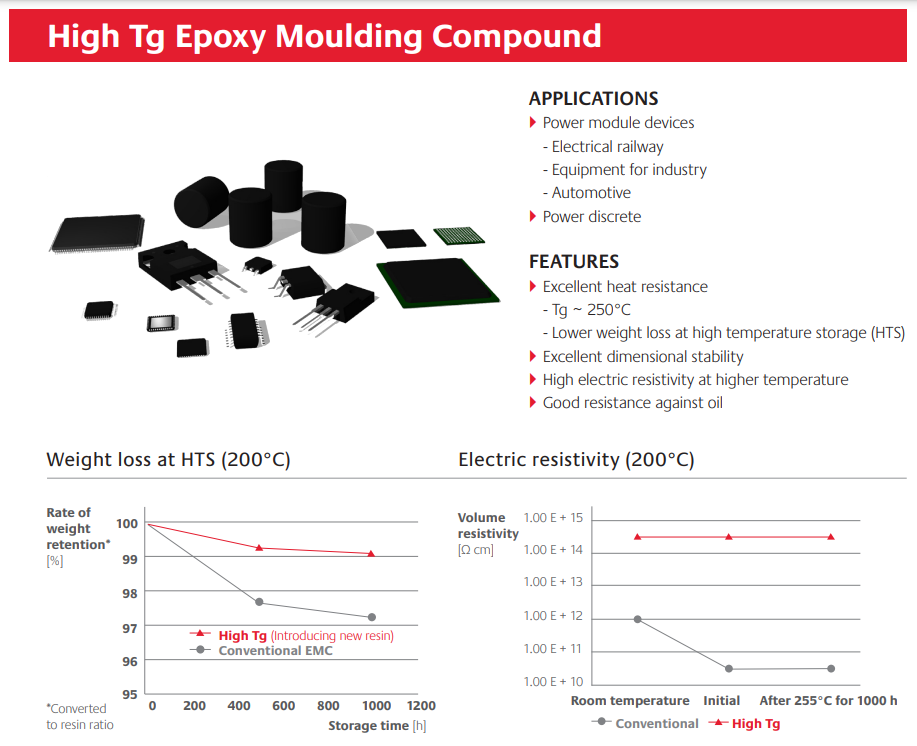
图源:京瓷化学
松下电工系半导体塑封料的著名企业,2018年推出扇出晶圆级封装 (FOWLP(*1)) 和面板级封装 (PLP(*2)) 设计的粒状半导体封装材料,这些新产品将提高用于可穿戴和移动设备的尖端半导体封装的生产率,并降低其制造成本。除了新商业化的颗粒状环氧模塑料之外,松下还提供片状封装剂(适用于 200 μm 或更小的封装厚度)以及液体封装产品。
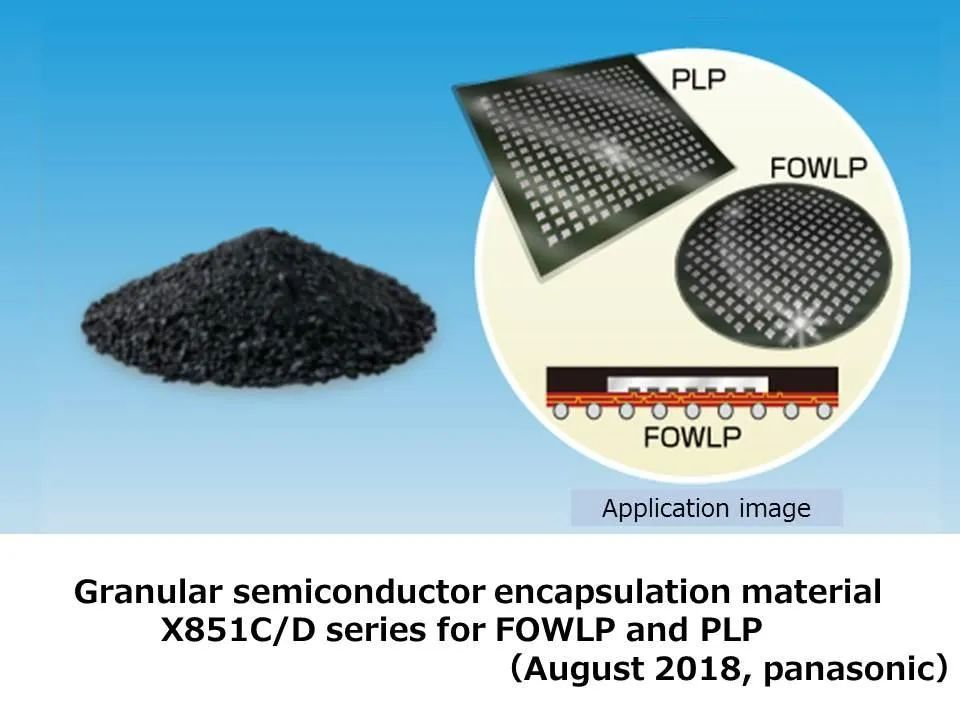 图源: 松下电工
图源: 松下电工
华海诚科是一家专注于半导体封装材料的国家级专精特新“小巨人”企业,公司专注于向客户提供更有竞争力的环氧塑封料与电子胶黏剂产品,构建了可应用于传统封装与先进封装的全面产品体系。应用于传统封装的基础类产品和高性能类产品已量产,性能达到外资厂商水平。公司主要产品为EMG系列。

图源:华海诚科
面向先进封装,公司研发了应用于QFN、BGA、FC、SiP 以及FOWLP/FOPLP等封装形式的封装材料,已陆续通过客户验证,有部分产品已实现小批量。华海诚科的颗粒状环氧塑封料(GMC)可以用于HBM的封装,相关产品已通过客户验证,现处于送样阶段,未来有望逐步实现产业化。公司已与长电科技、通富微电、华天科技、气派科技、银河微电、扬杰科技等业内领先及主要企业建立了稳固的合作伙伴关系。

华海诚科展台产品 图源:未来半导体/世界半导体大会2023
2023年4月华海诚科成功登陆科创板,成为国内第一家上市的环氧塑封企业,IPO募资6.33亿元拟用于投资“高密度集成电路和系统级模块封装用环氧塑封料项目”、研发中心提升项目及补充流动资金。其中高密度集成电路和系统级模块封装用环氧塑封料项目总投资2亿元,建成后将有效扩大公司高性能类与先进封装类环氧塑封料的生产能力,可形成年产1.1万吨环氧塑封料的生产能力。
国际贸易摩擦加剧的趋势下,当前正是国产EMC发展的黄金时代。华海诚科正在推进科技成果产业化、完善与丰富产品布局,有望率先实现先进封装用关键核心的EMC,进一步提升国内企业的竞争能力与市场份额。
中科科化新材料公司是专业从事半导体封装材料研发、生产和销售的高新技术企业。发源于中国科学院化学研究所,是国内最早从事环氧塑封料生产和销售的内资企业。承担国家“七五”、“八五“、“九五”重点科技攻关项目取得突破。“十一五”期间独立承担了国家02科技重大专项子课题;公司产品主要产品是KHG系列,从集成电路和功率器件封装都有相应的环氧塑封材料解决方案。在IC封装用EMC(QFN\DFN\BGA等)有成本低、高可靠优势;特殊用EMC有高Tg、超高导热和模组封装用环氧塑封料,部分产品已通过验证。


图源:科化新材料
公司针对先进封装、汽车电子和第三代半导体封装市场,规划了到2025塑封料产品开发路线图:在先进封装领域,推出BGA/LGA用EMC、FC-CSP/SIP封装用CUF和MUF型EMC、PLP/WLP封装用EMC Granule;针对工业级/汽车级器件/IC封装用高可靠的EMC;针对第三代半导体封装需求,开发高Tg EMC。

2022年,公司引入战投,战略融资3.1亿元并完成股改,成立江苏中科科化新材料股份有限公司。同时面向高端应用,启动二期环氧塑封料项目建设,项目总投资超过5亿元,厂房等基础设施一步到位,3~5年内陆续建成投产12条生产线,环氧塑封料年产能将超过3万吨、年产值超过10亿元,能满足先进封装、车规等高端应用的环氧塑封料生产需求。新项目建设担负着公司未来十年的发展重任,也肩负着今后数年国产材料替代的换挡要务。
衡所华威电子有限公司(原汉高华威)是一家从事半导体及集成电路封装材料研发、生产、销售和技术服务的企业。公司1983年开始涉足环氧塑封料业务,公司2021年全资收购韩国ESMO Materials并将其更名为Hysolem,韩国子公司主要产品包括用于半导体封装的黑色环氧塑封料。现有生产线12条,拥有Hysol品牌及KL、GR、MG系列等一百多个型号的产品。拥有环氧塑封料产品涵盖从低端(如桥块等)到高端(如BGA,MUF等)全系列产品的核心技术。 IC引线框架用EMC 图源:衡所华威
IC引线框架用EMC 图源:衡所华威
先进封装新产品方面,公司GR7XX系列产品是为满足高可靠性需求自主研发的中高端模塑料产品;GR60/GR60PT系列产品是为满足智能功率模块封装和可靠性需求开发的中高端系列产品;GR9XX系列产品是为满足QFN、BGA等封装需求自主研发的高端模塑料产品。GR900系列目前已经通过国内外多家公司考核进入小批量生产阶段。目前开发出硅粉粒径为20微米以下的新型高流动性MUF系列产品,即将进入示范应用阶段。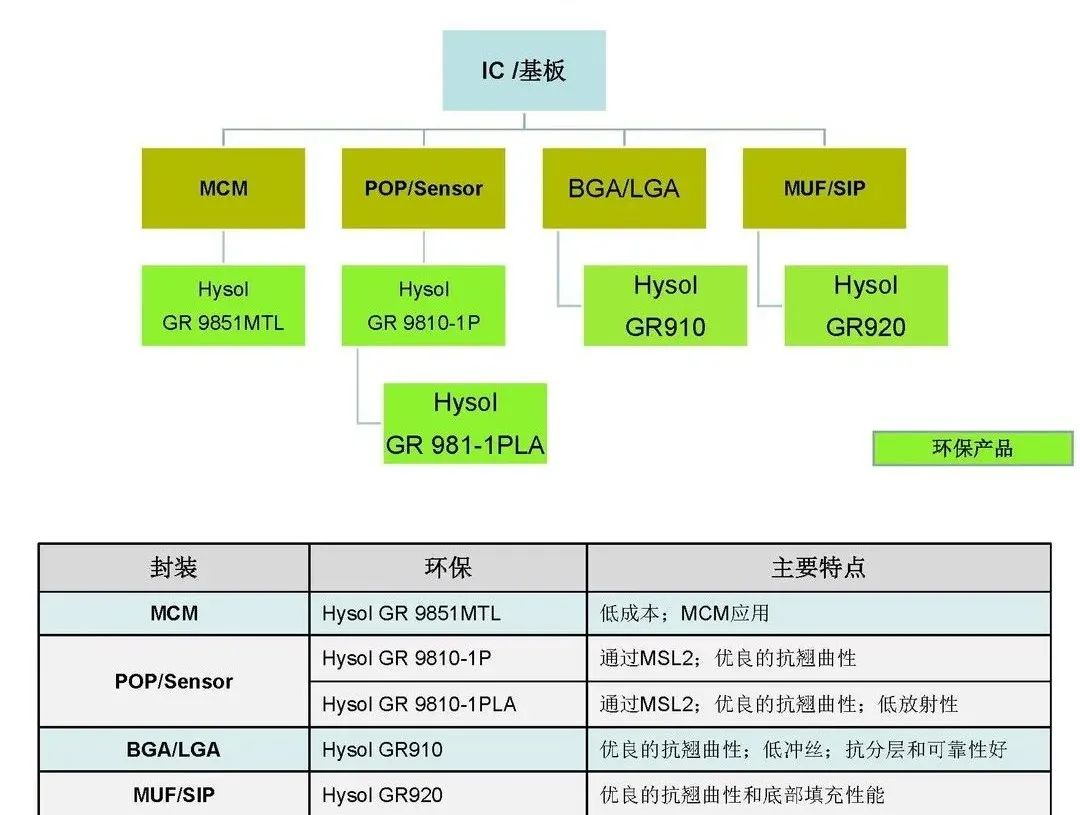 IC基板用EMC 图源:衡所华威
IC基板用EMC 图源:衡所华威
飞凯材料致力于为高科技制造提供优质材料,并努力实现新材料的自主可控。自2002年成立以来,飞凯材料始终专注于材料行业的创新与突破。在芯片级封装领域采用多元化的发展策略,先后收并购了台湾大瑞及昆山兴凯两家行业知名企业,完成对焊锡球及EMC环氧塑封料的布局——尤其飞凯材料的Ultra Low Alpha Mircoball产品,其最小制程工艺仅有50微米,填补国内空白,并已形成产业化。
飞凯材料环氧塑封料主要应用在功率分立器件、集成电路表面贴装和基板类封装产品。中高端封装环氧塑封料逐步由传统表面贴装IC SOP/SSOP、DFN、QFP产品向先进基板类封装BGA、FC、QFN、MUF转型。具有低翘曲、低吸水率、高可靠性的特点,能够通过高MSL等级,且为不含溴、锑等环保性EMC。公司正在强化相关的研发投入,积极推进高端EMC封装材料的研发布局和产品升级,不断拓宽产品领域。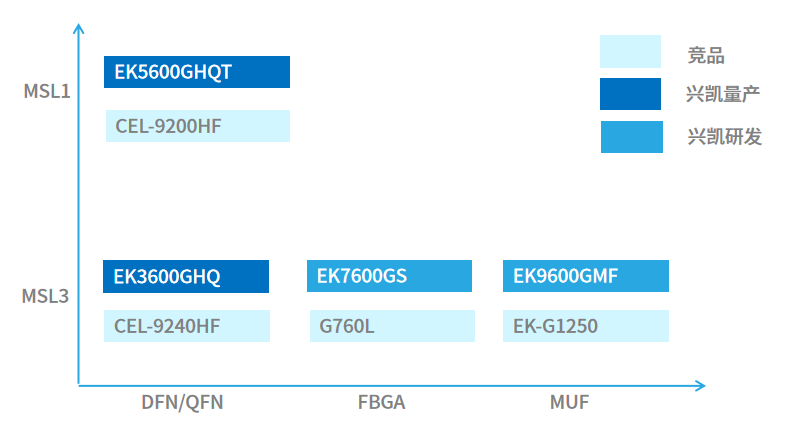 图源:飞凯材料
图源:飞凯材料
德高化成的目标是成为国际领先的材料公司,公司环氧树脂在半导体及功率器件封装高端 EMC 国产替代产品开发方面的进展有:面向车规要求的 PWIC和 MCU/SoC 微处理器应用所开发的高 MSL等级+高可靠性的 EMC,在满足 MSL1 湿敏等级的前提下,实现 b-HAST、HTRB、HTGB 等高可靠性要求,已经通过数家顾客验证;面向 DFN、QFN、LQFP 等薄型封装的高MSL1~2考核等级EMCGT-700系列,本年度取得多家用户验证通过并导入量产。用于NAND、SiP 及薄型 BGA等高阶 IC 封装的环氧树脂 EMCGT-310 持续批量交付。
道宜半导体是一家电子封装用环氧塑封料的研发、制造、销售和技术服务企业。在先进封装中有BGA/LGA/SD用的DYG800系列;MUF封装用的DYG900系列;SIP用DYG1000系列。新品研发上,DYG550系列高Tg(250℃)环氧模塑封料(EMC)现已通过国际权威第三方认证机构SGS 的CTI测试,其结果>600V,能极大提高了碳化硅模块的稳定性。公司总投资约2.5亿元临港工厂建有设备先进的环氧塑封料中试线1条、在建大生产线3条,达产后总产能约8000吨/年,主要用于生产中高端环氧塑封料产品。
浙江恒耀电子材料有限公司是浙江省科技型中小企业,主要产品HY-E系列、环保HY-EG系列环氧模塑料(EPOXY MOLDING COMPOUND),产品有六大系列上百个品种,用到集成电路DIP、SOP、QFP、BGA等型式封装中。
北京中新泰合电子材料科技有限公司是一家环氧模塑料研发、生产与销售为一体的国家高新技术企业,公司产品齐全,包含光电材料用TH-3000系列、分立器件封装用TH-100/200系列、SOT封装用TH-300/400系列、SOP封装TH-G500系列、QFN/QFP封装用TH-G800系列。
凯华材料为电子级环氧树脂复合材料产品生产商,处在电子级环氧树脂复合材料行业产业链中游,主营产品为环氧粉末包封料、环氧塑封料以及其他产品。2022年底凯华材料北交所成功上市,发行拟募集资金,用于新建项目可实现年产3000吨环氧粉末包封料和2000吨环氧塑封料的生产能力。




