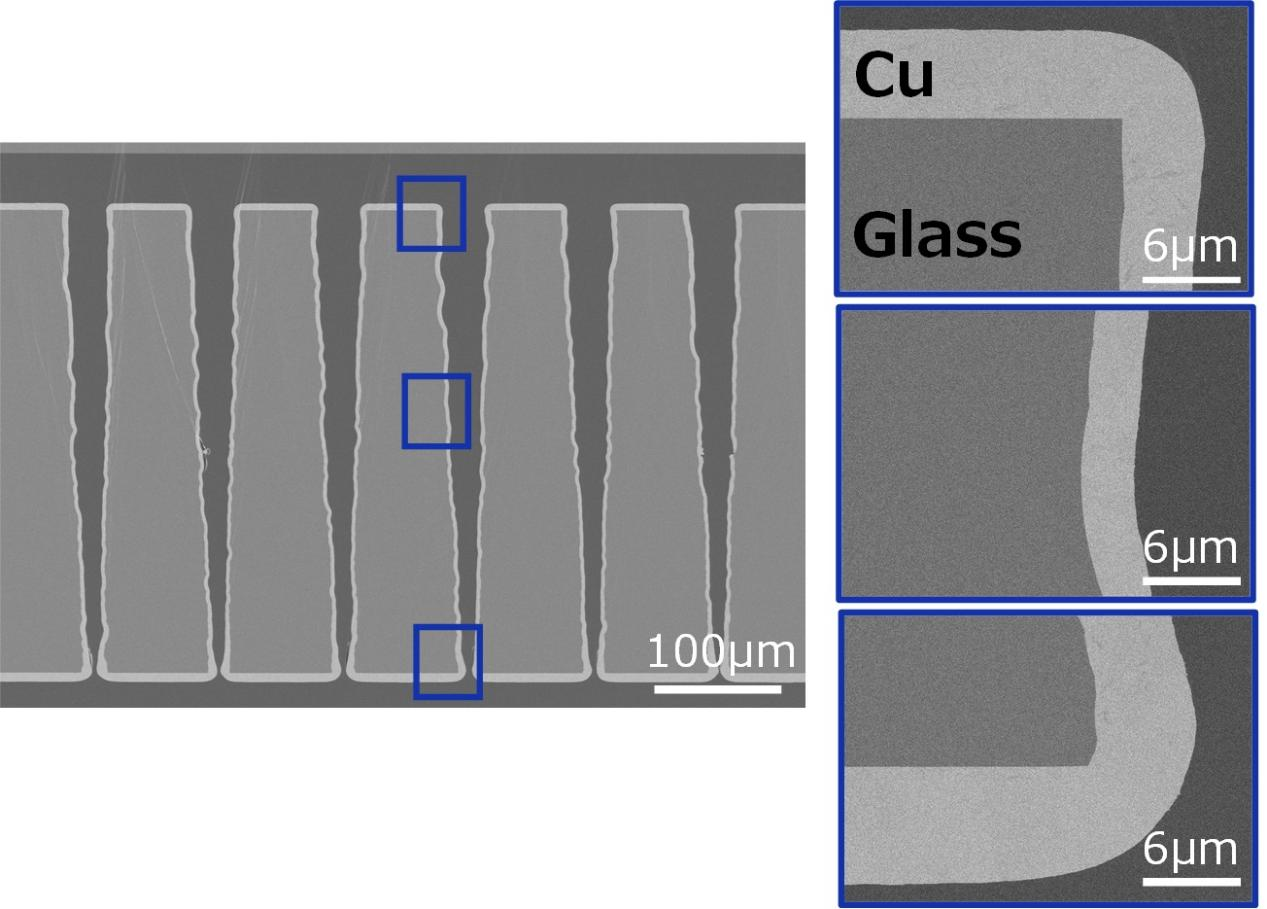 2025年12月,Toppan 凸版印刷株式会社将在其位于石川县能美市的石川工厂引入一条用于研发下一代510mm× 515mm半导体封装的试验生产线。该生产线计划于2026年7月投入运营。该生产线将进行有机RDL中介层的研究和开发,并验证量产所需的技术。
2025年12月,Toppan 凸版印刷株式会社将在其位于石川县能美市的石川工厂引入一条用于研发下一代510mm× 515mm半导体封装的试验生产线。该生产线计划于2026年7月投入运营。该生产线将进行有机RDL中介层的研究和开发,并验证量产所需的技术。
2025年重点攻克在玻璃芯封装、玻璃中介层以及带 RDL 的玻璃中介层、共封装光学器件的玻璃芯倒装芯片球栅阵列 (FCBGA),演究通过固化和光刻方法来降低玻璃应力的方法。Toppan 开发专为共封装光学设计的玻璃芯基板,计划于2027年投产。面板尺寸510mm×515mm,玻璃芯厚度400至800mm ,腔体深度50至200mmm ,可选 60µm TGV直径 130µm 间距。Toppan 还成功加工了 TGV 和腔体,这可以应用于玻璃芯 FC-BGA 基板和玻璃中介层。Toppan推进采用玻璃芯、玻璃中介层和使用玻璃载体的有机 RDL 中介层的下一代封装基板的技术开发已进入样品验证阶段,目前主要客户是博通。
有机RDL中介层的开发被选入新能源产业技术综合开发机构(NEDO)的“后5G信息通信系统基础设施强化研发项目/先进半导体制造技术开发(补贴)”。在该开发项目中,公司将与大阪公立大学、富山县立大学、东京理科大学等机构合作,开发用于有机RDL中介层的亚微米布线制造技术。公司希望利用这项研究成果,同时实现高容量数据传输和低功耗。此外,公司还通过与高校合作,致力于人才培养和科研人员的招募。

5月27-29日,无锡国际会议中心,iTGV2026第三届国际玻璃通孔技术创新与应用论坛将强势回归,本届以“重构玻璃基板技术路线,赢战玻璃基板量产元年”为大型主题,诚邀海内外AI设计公司、玻璃基板先进封装与核心材料工艺的同仁参与。iTGV2026将设立
· 年度主论坛:第三届国际玻璃通孔技术创新与应用论坛)(29日上午大会场)
· 分论坛一:GCP玻璃线路板技术峰会(29日大下午大会场)
· 分论坛二:FOPLP扇出面板级封装合作论坛(29日大下午分会场)
· 分论坛三:iCPO 国际光电合封交流会议(29日大下午分会场)
· 分论坛四:CoPoS技术论坛(27日全天分会场)
May 27-29, 2026,Wuxi International Conference Center,ITGV will return strongly. This year, with the theme of "Reconstructing the technical route of glass substrates and winning the first year of mass production of glass substrates", we sincerely invite A at home and abroad; I design company, advanced glass substrate packaging and core material technology colleagues participated. ITGV2026 will be established:
iTGV2026 Main Forum:The International Through Glass Via Technology Innovation and Application Forum;
iTGV2026 Sub-forum:Glass Circuit Plate Technology Summit (GCP 2026)
iTGV2026 Sub-forum:Fan-Out Panel Level Packaging Cooperation Forum(FOPLP 2026 )
iTGV2026 Sub-forum:International Co-packaged Optics Conference(iCPO 2026)




