在新兴应用场景的消费支撑下,FOPLP技术因兼具大产能及成本优势,是功率半导体、传感器、通信等车规级/芯片生产的最佳解决方案。电动车持续带动国产车规级芯片市场需求,将促进板级封装技术同步发展。 消费者对电子产品的高便携性和多功能化追求,以及市场对 AIoT、5G 和智能驾驶IC 结构紧凑、性能更好且更具成本效益的需要,导致了先进封装技术的繁荣。过去数年,扇出型封装是成长最为快速的先进封装技术,扇出面板级封装 ( FOPLP ) 是晶圆级扇出封装的延伸,正在成为占领有具体需求的新兴市场。
扇出面板级封装(FOPLP)是指将半导体芯片重新分布在大面板上而不是使用单独封装的先进封装技术。FOPLP 能够将多个芯片、无源元件和互连集成在一个封装内,与传统封装方法相比,该技术提供了更大的灵活性、可扩展性和成本效益。
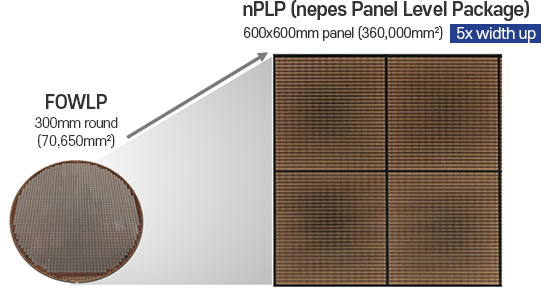 图源:Nepes
图源:Nepes

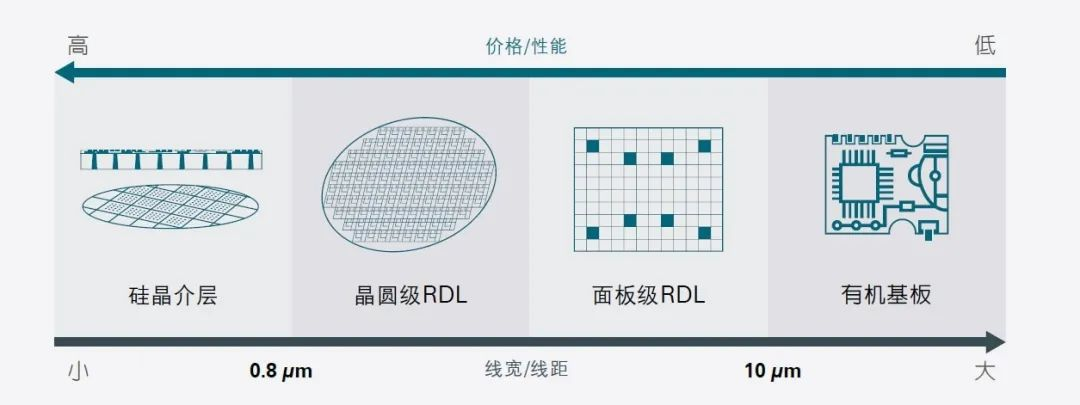 图源:Manz
图源:Manz
对于FOPLP而言,采用方形面板作为封装载板来代替采用晶圆作为载板封装。这些方形载板的材质可以选择金属、玻璃和高分子聚合物材料。同时FOPLP利用了较大的基板尺寸。
提供具有成本效益的大尺寸互连,面板级有更高的产出效率、更少的物料损耗和更大的有效曝光面积。
就面积利用率而言,FOPLP高达95%,而FOWLP低于85%;
以主流12"/300mm晶圆与300mm正方形玻璃为载具做扇出型封装, 方型载具产量为晶圆的1.4倍。再以主流12”晶圆与主流方形载具尺寸约600mm相比, 方形载具产量为晶圆的5.7 倍;
Yole数据显示,从200mm过渡到300mm大约能节省25%的成本,从300mm过渡到板级,则能节约66%的成本。
现阶段不需要最先进制程和设备,也不需要太细的线宽/线距;
FOPLP还具有多种性能优势,例如更高的器件密度、改进的电气性能和增强的热管理。
板级封装相比传统封装在提升性能的同时,能够大幅降低成本,因此板级封装会代替传统封装成为Sensor、功率IC、射频、链接模块、PMIC等的最佳解决方案,如汽车中约66%的芯片价值可以使用FOPLP技术生产,是车规级芯片生产的出色解决方案。FOPLP技术具备巨大的成长潜力,预计未来几年将出现显著扩张,Yole数据显示,2022年FOPLP的市场空间大约是11.8亿美元,预计到2026年将增长到43.6亿美元。
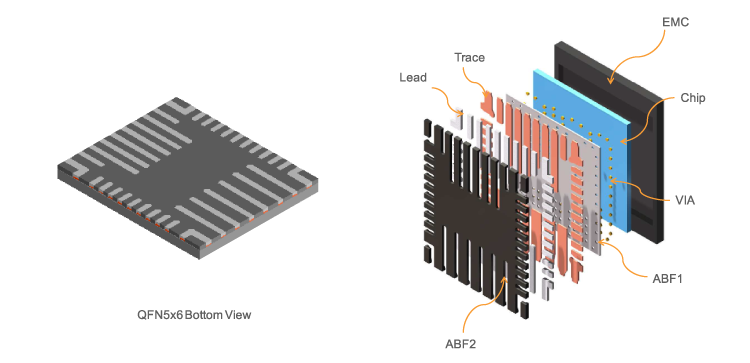
面板封装产品结构 图源:华润微
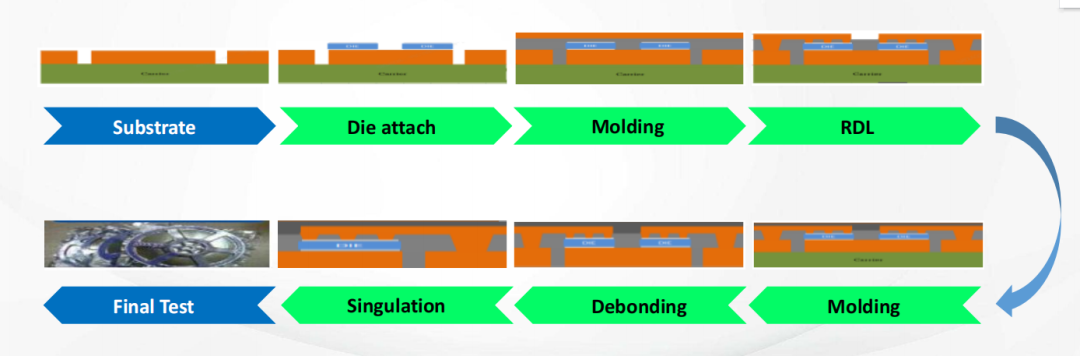 面板封装扇出简要工艺流程 图源:中科四合
面板封装扇出简要工艺流程 图源:中科四合
FOPLP所面临的技术挑战和极限
相对于晶圆级扇出封装成熟的尺寸标准化、设备和材料工艺的完整化,FOPLP仍然面临着精度、翘曲、良率以及配套设备的挑战。
尺寸规格上,虽然SEMI仍努力将这一问题标准化,但方形板一直在变大。目前已经有:300X300mm、510mmX415mm、515mmX510mm、600mmX600mm、615X625mm、620mmX750mm、700mmX700mm、800X600mm、800x800mm……当然,大尺寸的方板具有更好的成本优势,尺寸越大会带来基板翘曲的问题,会影响到精度和良率等问题。
 600 x 600cm基板 图源:Nepes Laweh
600 x 600cm基板 图源:Nepes Laweh
RDL方面,FOPLP线宽/线距当前达到10um/10um,但也有厂家在5um到2μm上取得率先突破。未来大有遵循与晶圆级封装相同流程的趋势,甚至可能突破面板级封装的物理限制至1μm 。若可以真正量产5μm-5μm的工艺水平将足以扩展到更多有性能、散热、效率需求的中高端应用上,特别是有源和无源器件的多芯片、异构集成:
FOPLP要实现更高的分辨率,线宽线距5um及以下高密度RDL仍需进一步克服技术层面的难题。大尺寸基板移载上面临玻璃、不锈钢和聚合物各种翘曲载体处理问题以实现精准移动。
在这一过程演进中在大面积均匀图案、均匀电镀上,大面积基板上线宽线距从20um/20um,到15um/15um再到10um/10um时,异质整合如何做到蚀刻率均匀、大面积电镀均匀性。目前顶级厂家的均匀度90%,仍需要时限去突破95%。
设备上,设备需要新的支持大尺寸板级的能力,板级封装产线可以用到液晶面板厂50%的设备(3.5代线或4代线),重点增加的是RDL制造设备、贴片设备,还需要开发特殊的检测及测量工具以及激光/热释放层、介质层材料。
市场份额上,过去数年FOPLP一直处于爬坡阶段。扇出封装仅占整个先进封装市场的10%,面板级解决方案仅占整个扇出市场的10%。因为板级封装巨大的成本优势和性价比,OSAT、IDM、基板制造商和平板显示(FPD)厂商都在力争通过FOPLP技术涉足先进封装业务。三星、群创、力成、日月光已取得量产,中国大陆的几家具备量产能力或已经量产,扇出面板型封装或迎来全面的爆发。
三星一呼,诸强百应
三星电子是第一家FOPLP进入量产的厂商。2015在与台积电竞争Apple手机处理器订单失利后,决定在2015年成立特别工作小组,并与台积电研发的InFO-WLP(扇出型晶圆级封装)技术一较高下,三星电子携手其集团旗下的三星电机战略性开发出面板等级FO封装技术。
2019年三星电子收购三星电机的半导体扇出型面板级事业。三星电机是三星集团下以研发生产机板为主的企业,集团内所有对于载板在技术或材料上的需求,均由三星电机主导开发。虽说如此,尽管三星电子全力研发比FOWLP更进步的扇出型面板级封装。转移了一些旧的液晶显示器生产线,并将其转变为封装工厂。三星电子强调,FOPLP成本竞争力很高,因为它是一种在方形基板面板上进行封装的技术,而不是在晶圆等圆形基板上进行封装。
三星电机于2016年投资2640亿韩元在忠清南道天安建立生产线并开始了PLP项目。2018年开始应用于自家智能型手表Galaxy Watch的处理器封装中。这是FOPLP的全球首次量产。三星最初有使用 510x415mm 尺寸的面板制造 FOPLP,也开发有高达 800x600mm 的面板。因此,面板尺寸可以根据客户要求进行更改。
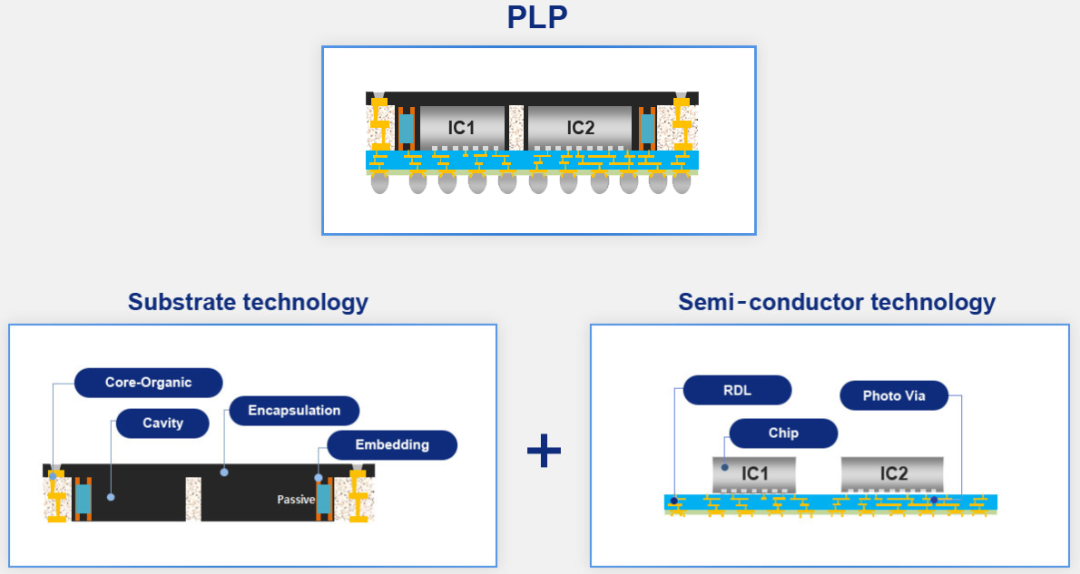 图源:三星
图源:三星
最初,FOPLP主要用于移动应用。2020年开始的5G、AI、自动驾驶和服务器需求导致对模块化和高速数据处理的需求急剧增长。兼顾性能和成本驱动优势的FOPLP可以满足多芯片封装方面的这些需求,FOPLP异军突起,拓展到射频芯片、电源芯片、芯片模组、高频芯片、物联网和人工智能芯片的先进封装应用。在这种趋势下带动下,三星、群创、力成科技、日月光和纳沛斯(Nepes)结合自身的工艺能力投资扇出型板级封装技术的量产。同时国内一些IDM、封装厂提前布局FOPLP。
群创光电
群创光电首度提出一项前所未有的概念——Panel Semiconductor。能够高度整合晶片的先进封装技术,成为群创在跨界半导体产业发展的重要方向之一。
 图源:群创光电
图源:群创光电
群创首先将活化现有G3.5产线, 以业界超大尺寸G3.5 FOPLP (620mm X 750mm) Glass Panel,开发线宽介于2μm ~10μm的中高阶半导体封装,其面积是300mm Glass Wafer的7倍。目前在FOPLP技术开发已克服Warpage 问题,加上方型之高玻璃利用率,可发挥容纳更多的I/O 数、体积更小、效能更强大、节省电力消耗等技术优势,进一步提供客户更有竞争力的成本及创造更大的利润价值。未来更放眼FOPLP技术与车用面板显示器结合,群创借由垂直整合供应链,开启崭新格局。
力成科技
力成科技在全球封测服务中居于领先地位,也是率先布局FOPLP技术并量产的领导者之一。2018年全球第一座使用面板级扇出型封装制程量产基地,正式布局高阶封装领域。成功运用于联发科PMIC和音频收发器上。
目前力成科技在FOPLP技术上提供 4 种封装结构,有 Chip First的CHIEFS®方案 、Chip Last的CLIP®、Chip Middle的PiFO®以及Bump FreeBF2O®,其技术优势如下:
多设备,包括用于异构集成的有源设备和无源设备;
细间距高铜柱可实现垂直器件集成;
通过精细 RDL L/S 可实现高密度互连;
低温固化电介质以满足大多数设备要求,包括逻辑和存储器;
卓越的设计、工艺和故障分析工程能力,可实现坚固的封装;
热、机械和电气仿真能力可为客户提供最佳封装设计和 BOM;
交钥匙 FOPLP 组装和嵌入式芯片 FO-RDL 基板均可提供。
 图源:Powertech Technology
图源:Powertech Technology
力成科技FOPLP技术兼容特征有:系统级封装 (SiP) 可实现多芯片和无源元件集成;精细的RDL L/S和最短的信号传输路径,具有良好的电气性能;细间距电镀高铜柱。可用于扇出 PoP兼容从低 I/O 到高端的逻辑和存储设备,更广泛的应用,包括电源、射频、消费电子、移动、存储、汽车、HPC 和 AiP。力成科技未来将加大应用FOPLP)技术于高效能运算、AR、AI、物联网与智慧驾驶。
日月光
日月光是最早布局面板级扇出型技术的领导厂家之一。2019 年底产线建置完成,2020 下半年量产,应用在射频(RF)、射频前端模组(FEM)、电源(Power)、Server。据悉,该技术当初获得了获得华为海思的封测订单。
为满足需要更大内存以及计算能力的网络和人工智能应用集成需求,2022年日月光推出了推出VIPack先进封装平台,提供垂直互联集成封装解决方案。VIPack就是以3D异质整合为关键技术的先进互连技术解决方案,建立完整的协同合作平台。
Nepes Lawe
Nepes Laweh 是系统半导体行业的领先公司,拥有先进的扇出封装解决方案。在第四次工业革命时代,当半导体变得更加精致和先进时,例如5G、自动驾驶汽车和智能手机,公司提出了基于 nPLP ™技术:
使用600mm大方形面板的扇出封装的新标准上,利用率跃升至92%,仅就面积利用率而言,成本降低了25%以上;
通过自适应图案化控制芯片移位和翘曲6面保护通过M系列(300mmRd)实现更高的板级可靠性;
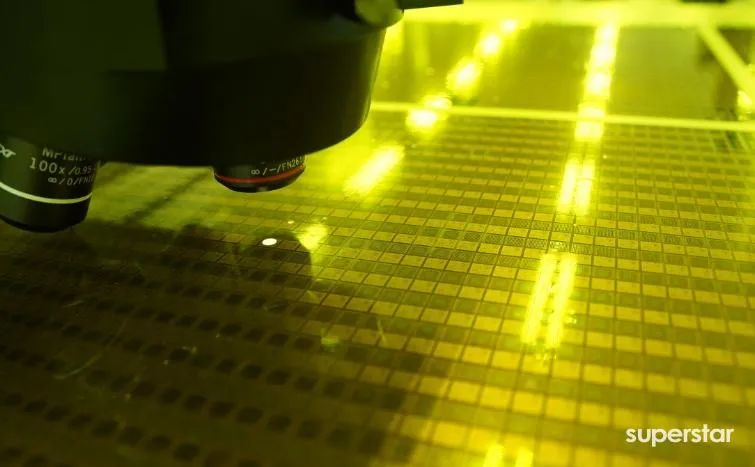 2017年5月15日,Nepes成功将现有使用昂贵的半导体设备和材料的晶圆级封装(WLP)制造转换为使用液晶显示(LCD)设备和材料的面板级封装(PLP),这种全球首创也意味着量产的新挑战即将到来。图源:superstar.news
2017年5月15日,Nepes成功将现有使用昂贵的半导体设备和材料的晶圆级封装(WLP)制造转换为使用液晶显示(LCD)设备和材料的面板级封装(PLP),这种全球首创也意味着量产的新挑战即将到来。图源:superstar.news
Nepes于2014年开始开发FOLPP技术,当时通过整合其子公司的TSP(触摸屏面板)设备技术开始批量生产FOWLP。当时子公司Nepes Display拥有的TSP技术,是一种通过在超薄大尺寸玻璃上形成精细图案来取代ITO薄膜,从而减少厚度并最大化触摸灵敏度的技术。Nepes凭借其先进的封装技术和子公司的显示技术,于2017年在600mm大方形面板上成功实现了扇出封装。2019年,Nepes收购了位于菲律宾的扇出工厂和最新的扇出技术。
2021年 Nepes在Cheongan Campus PLP 的工厂竣工,并推出了首个使用 600 x 600mm 面板的扇出面板级封装业务并全面量产。该工厂年可生产多达 96,000 块基于 600mm PLP 的面板,有能力为智能手机、汽车和物联网等各种应用提供非存储半导体所需的高密度封装解决方案,并符合客户需求。
 集成 4 层 DRAM 内存和 AI 处理器的堆叠封装(侧视图)
集成 4 层 DRAM 内存和 AI 处理器的堆叠封装(侧视图) 集成 4 层 DRAM 内存和 AI 处理器的堆叠封装(正面)图源:Nepes
集成 4 层 DRAM 内存和 AI 处理器的堆叠封装(正面)图源:Nepes
Nepes 预计在可预见的未来,对 FOPLP 的需求将出现爆炸式增长,因为对 SiP 和异构芯片解决方案技术的需求也将蓬勃发展,有望利用基于扇出技术的异质结技术和大容量接口技术,实现人工智能半导体、边缘计算、云服务器等领域的核心技术。
大陆FOPLP迅速崛起
在部分国外大厂的带动下,国内扇出面板级封装厂商正在乘胜追击,已经量产或具备生产能力的厂家如下(排名不分先后顺序):
华润微电子于2018年成立矽磐微电子(重庆)公司从事面板级封装业务,面板级封装技术有效解决了Chiplet封装成本高昂的问题,更适用于功率类半导体封装异构集成化:
ONEIRO封装是矽磐微电子具备自主知识产权的扇出封装技术,采用嵌入式封装结构,其产品设计灵活,产品结构发展空间巨大,可以将晶圆级封装与基板封装相结合,一次性完成10万颗产品加工,有效提高产品加工效率;
在面板级封装技术方面拥有QFN、CSP、LGA、BGA、 Dual Side、SIP封装结构类别,封装结构具备无键合点、无焊接点、无粘结材料、无需框架和基板特点;
采用载板级RDL加工方案,最大尺寸可达580X600mm,厚铜多层布线技术RDL厚度10~40um;
具备高度集成、大功率、高散热、高可靠性、高通流能力,封装翘曲可控;
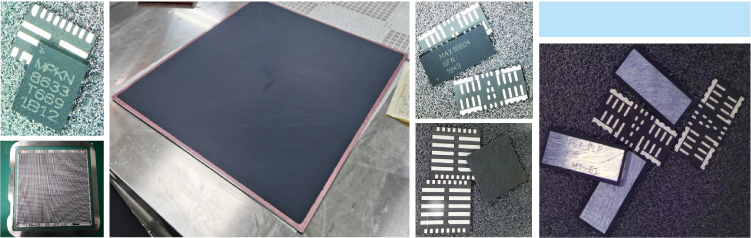 图源:华润微
图源:华润微
矽磐微电子完成了汽车电子可靠性能力通过AEC-Q100Grade 1认证,率先在国内完成65um BPP MCU PLP Fan-out量产化和60um BPP MCU+Driver PLP Fan-out 工控器件量产化。成功应用于模拟、数字、混合信号、GaN功率器件等产品的大批量产,以满足国内外IC设计公司封装集成需求。
奕成科技是国内板级高密封装技术领域的领先者,是北京奕斯伟科技集团生态链投资孵化的重点企业之一。公司主要从事板级系统封测集成电路业务,载板尺寸为510mmx 515mm,技术平台可对应2D FO、2.xD、3D PoP、Embedded Die四大板级系统集成技术方案,在芯片偏移控制、翘曲度、RDL等核心工艺指标上已达行业领先水准。
2D FO技术平台,无需封装基板可进行单芯片、多芯片系统集成,封装尺寸更小更轻薄,具有高精度的RDL(RDL L/S: 8/8um)布线及优异的电热性能;
2.xD平台采用高密度RDL Interposer进行互联(RDL L/S: 2/2um),无需Si Interposer,可进行同构/异构多芯片集成,有效简化供应链,实现高密互联;
奕成板级3D PoP平台采用多层高精度RDL布线(RDL L/S: 6/6um),将逻辑芯片和存储芯片进行上下堆叠互联;
Embedded Die平台,采用小尺寸Si Bridge进行局部超高密度互联,实现多组件芯片间高速通信。
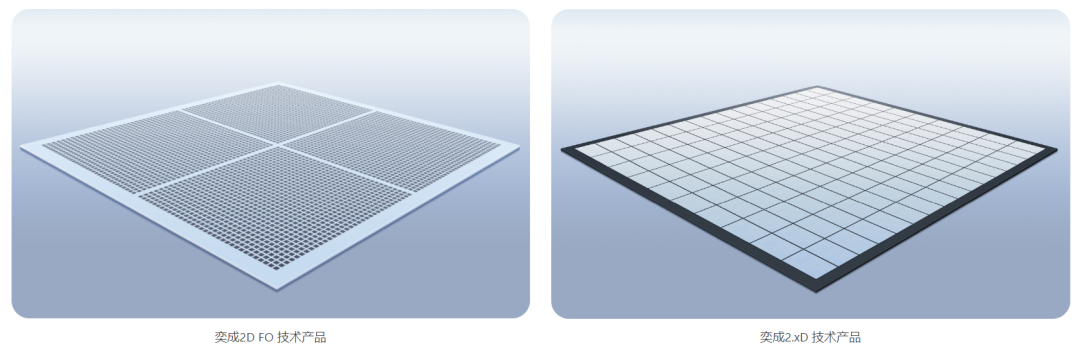 图源:奕成科技
图源:奕成科技
2023年4月,奕成科技高端板级系统封测集成电路项目点亮投产。该项目的投产标志着中国大陆首座板级高密系统封测工厂正式进入客户认证及批量试产阶段。2023年8月成都奕成科技完成超10亿元人民币B轮融资,本轮融资完成后,奕成科技将继续夯实技术实力,加快客户验证及产能提升。
合肥矽迈微电子是一家专注于半导体先进封装的科技企业,建成了国内首条具备量产能力的基板扇出封装生产线,并率先完成工艺开发,客户认证和试验量产,目前已经量产3年,量产产品包括电源管理类,射频类,系统模块等等:
优势特点:基于过程效率的成本优势;基于结构优化的性能优势。产品覆盖范围广,单芯片IC和功能模组;
关键工序设备自主开发。实现了基于扇出型工艺的多层堆叠封装结构。已经授权发明专利20多项,另外60多项发明专利在审查中。
中科四合为国内领先的Panel-Fanout 封装技术制造特色产品(功率、模拟类芯片/模组)供应商和集成电路封装基板供应商,在板级封装技术领域有出色表现:
可实现低电阻、低热阻等低寄生参数电路互联;
可实现高密度、多芯片集成、高散热封装;
可实现大板尺寸≥500X400mm;
完成了ESD、SBD、MOS及GaN等功率器件及模组的PLP封装量产平台的建设,其中ESD器件可靠性符合汽车电子标准AEC-Q101认证。
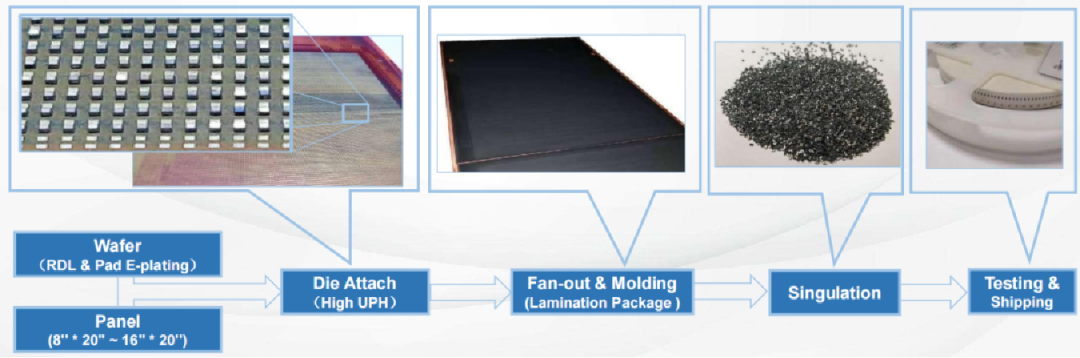 适合功率器件/模组的Panel级Fan-out封装工艺平台 图源:中科四合
适合功率器件/模组的Panel级Fan-out封装工艺平台 图源:中科四合
目前中科四合在深圳龙华区和厦门海沧区均设有制造工厂:其中深圳工厂面积约为2700平米,2017年利用大板级扇出封装技术实现TVS产品量产,成为全球最早将板级扇出封装技术量产于功率类芯片的厂家之一。主要产品为面向消费类市场基于Panel-Fanout封装生产ESD、SBD等二极管器件,年出货量超过4000KK。
 图源:中科四合
图源:中科四合
中科四合厦门工厂位于海沧半导体产业园,场地共计2.4万平米,PLP产品线于2022年Q4首批板正式投板;厦门工厂以多芯片集成的三维板级扇出封装量产技术为主,工厂重点面向工业、通信、汽车等行业基于多芯片集成的三维板级扇出先进封装技术开发和量产功率、模拟类芯片/模组,产品类型涵盖MOSFET、GaN、DC-DC、IPM、ECP等。截止到2023年8月份已完成ESD,MOS及GaN功率器件及模组的PLP封装量产平台的建设,并具备量产能力。
广东佛智芯微电子是广东省半导体智能装备和系统集成创新中心承载单位,由广东省及其地方政府、国内半导体装备龙头企业、科研院所等共同出资建设,在产学研领域拥有雄厚实力。结合现有半导体制程工艺设备和后道载板制程工艺装备的优势,佛智芯打造了半加成法扇出封装先进的线路创成工艺(i-FOSATM),具备工艺先进 、成本合理、供应链安全的特性,建设国内首条高性价比板级扇出型封装研发线和示范线:
核心工艺能力方面,图形层电镀均匀性10%@3σ;图形层平整度±4um;在精细路线技术能力上,板级高深宽度比铜柱工艺50μm,AR>2,板级高密度SAP工艺能力10um级,为全球板级扇出最高技术水准;
在尺寸上,以300×300mm为突破点,逐步切换到600×600mm,最大尺寸可达615X625mm,良率95%以上;
拥有核心技术:玻璃通孔刻蚀\玻璃盲孔刻蚀\玻璃通孔金属化\玻璃表面金属化。
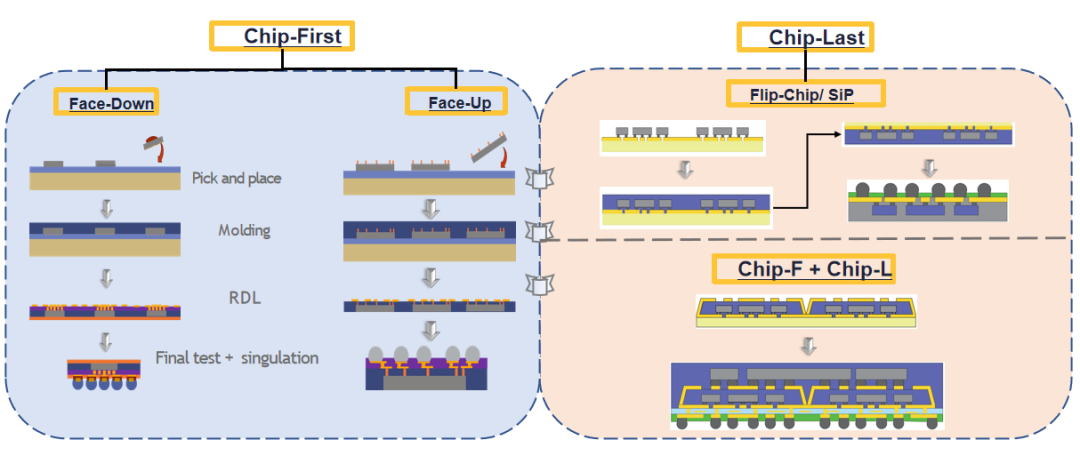 工艺路线能力 图源:佛智芯微电子
工艺路线能力 图源:佛智芯微电子
基于佛智芯示范线,打通Chip-First、Chip-Last、3D/SiP核心工艺。佛智芯微电子形成了针对同一类型产品的系统化成套技术与解决方案。已出货单芯片MOSFET封装、多芯片异构集成封装、玻璃基高密度FCBGA基板、BOS(Bridge on substrate)封装,或在2023-2024年实现量产。
为增加板级封装技术创新与合作,佛智芯通过建立“板级扇出封装创新联合体”,打造产业链共性平台,联合体成员包含亚智、华为、华进等40多名国内外企业。
天芯互联为深南电路全资子公司,同样拥有板级扇出封装(FOPLP)平台,为客户提供高集成小型化的半导体器件模组封装解决方案和半导体测试接口解决方案。
在大尺寸板上突破新设备工艺
如今FOPLP技术并未实现行业标准化,野蛮生长中各厂家都大力投资,为相关设备和材料带来了新的机遇。改善面板翘曲、均匀性与良率关键在于RDL制造和客制化生产线等方法,因此选择灵活组合的客制化方案十分重要。
Deca Technologies是一家独立的技术开发和授权公司,专注于M系列扇出和自适应图案化技术。面对面板级工艺的设计挑战,推出Adaptive Patterning® 技术。不同于传统的基于掩模的光刻和设计系统,该技术可以轻松解决面板级 (PLP) 工艺中的芯片移位问题。通过将高速、准确光学位置检测与可扩展的计算集群相结合,为每个单独的设备生成定制布局,以补偿测量的位置误差。此外,内置的实时设计规则检查 (DRC) 保证了成功的结果。
复杂程度的多芯片集成 来源:DECA
Manz是全球知名半导体制造商,是板级封装RDL工艺的市场领跑者之一。Manz认为,在大面积板级封装生产时,要达成高均匀线路重分布层的实践,大面积电镀设备是关键。2022年,Manz以优异的设备制程经验以及机电整合能力推出新一代板级封装 RDL生产线采用大面积电镀设备,涵盖传统强项湿法化学工艺的洗净、显影、蚀刻、剥膜与关键电镀铜设备,同时实现全线的自动化生产。最终实现生产面积达基板尺寸700mm x 700mm,面板电镀均匀性U%≥90 %,最小线宽/线距5μm / 5μm。创下板级封装生产效率的新里程碑!
 图源:Manz
图源:Manz
2016年,Manz进军半导体先进封装领域。2017研发并售出第一台用于半导体先进封装FOPLP的湿法化学设备。2019 Manz交付首条半导体板级封装全自动RDL生产线。至此Manz一直在引领基板尺寸的进步,面板尺寸也从515mm x 510mm开始,演进至600mm x 600mm,再到700mm x 700mm,未来恐将进一步提升。
SEMSYSCO(2022年被泛林收购)专注于半导体及相关行业提供湿法加工解决方案,拥有大型平板加工提供技术组合方案支持,针对小芯片间或小芯片和基板间异构集成的清洗和电镀能力,包括支持扇出型面板级封装这样的颠覆性工艺。SEMSYSCO在2016年推出FOPLP封装平台 ——Kallisto,用于处理大于300x300mm至Gen5.1基板的面板垂直腔室。
 图源:SEMSYSCO
图源:SEMSYSCO
Evatec 提供面对先进封装市场量身定制,适用于各种封装形式的PVD解决方案。Evatec 市场领先的CLUSTERLINE® 600 机台支持扇出型面板级封装应用和下一代IC基板技术。它集成了用于先进封装的除气,刻蚀和镀膜功能。可根据需求轻松配置和扩展至最大650 x 650mm 的面板生产尺寸。
 图源:Evatec
图源:Evatec
为满足高产能大型基板的封装需求,CANON在2020年发售了光刻机“FPA-8000iW。该款新产品是佳能半导体光刻机产品线中,首个可对应大型方形基板的面向后道工序的光刻机。为应对使用方形基板进行封装工艺的需求,佳能开发了可以搬送515×510mm大型方形基板的新平台。另外,针对在大型方形基板上容易发生的基板翘曲的问题,通过搭载新的搬送系统,可在矫正10mm大翘曲的状态下进行曝光。佳能自主研发的投影光学系统可实现52×68mm的大视场曝光,达到了方形基板封装光刻机中高标准的1.0微米解像力。
 FPA-8000iW 图源:CANON
FPA-8000iW 图源:CANON
华封科技是全球领先的先进封装高端贴片机供应商,面板级封装是全新的封装技术,需要全新的封装设备,而面板级封装其中关键的设备之一就是面板级贴片机,是影响良率和效率的关键环节。基板尺寸更大,对应机台尺寸更大,Pick & Place动作的路径更长,对机台的效率、运动机构的一致稳定、视觉系统的软硬能力、信息综合处理的能力和有效性都是巨大的挑战。
2023年6月华封科技发布面向面板级封装的最新代一高精度贴片机——“狮子座”AvantGo L6,再次将面板级封装贴片机能力提升至全球领先水准,设备可前后机同时作业,最大支持700mmx750mm载盘冷、熟焊接;拥有高精度(±3μm@3σ,±0.01°@3σ)、高速度(10k UPH)双动梁多键合头;支持最大100mm×100mm芯片正反贴装;独立双晶圆台同时处理多种芯片;占地面积最小至1500mm*2000mm……该贴片机在性能和指标均足了一线客户需求。目前已经向国内外的客户供货,其中,某国际半导体厂商进行了大批量采购,该客户在汽车半导体领域排名全球前三。
 AvantGo L6 图源:Capcon
AvantGo L6 图源:Capcon
ASMPT以晶圆级封装技术的高精度后端半导体设备而闻名,为面板级制造商提供多样化组合方案。NEXX Stratus P500 面板级电镀工具能够在高达 510 x 515 毫米的面板上提供晶圆级电镀精度、提供 <10 um RDL L/S 和一系列先进的封装功能。SIPLACE CA是世界首个表贴装置平台,配合特大面板封装,提供更大性能及更高生产速度,相关贴片机器根据UPH不同可以达到2um的高精度。另外还有锡膏印刷及锡球排放系统DEK GALAXY、器件分离设备LASER1205、检查、测试及封装平台SUNBIRD……

ECD 510 x 515 mm 面板加工 图源:ASMPT
Fasford是日本的一家半导体生产设备的制造商,是FUJI集团旗下一员。公司在FOPLP领域有FC300设备,适用于FOPLP封装生产的对应大型面板上片的上片机。通过新研发的Dual Gantry Drive实现设备的高精度和高生产性。可对应最大面板尺寸为750×750mm,最大上片区域为670×670mm。通过对应多晶圆(生产参数切换/治具更换)实现多芯片生产。

图源:Fasford
针对FOPLP面临的晶粒偏移和翘曲问题,ERS公司在2023年相继推出了全自动热拆键合/翘曲矫正一体机ADM330,全自动翘曲矫正机WAT330,以及全自动面板级热拆键合机APDM650等设备,其中PDM650最大可处理650x650mm面板规格,温度均匀性可稳定在 ±3℃ @200℃。另还有Wave3000可以准确地测量晶圆在特定处理位置的变形,并提供全面精准的翘曲分析。
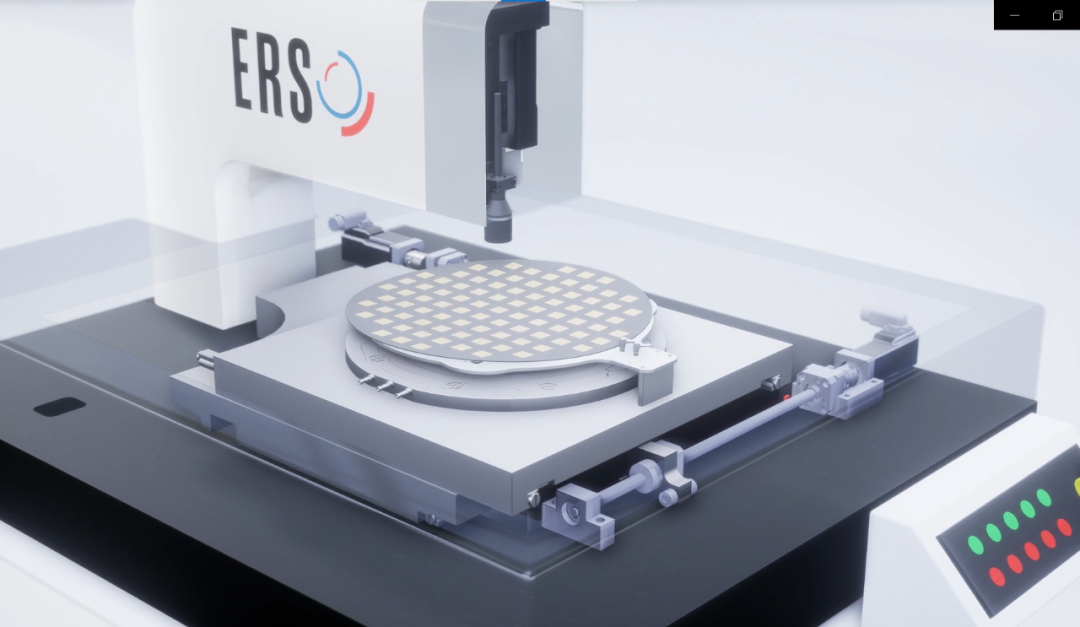 图源:ERS electronic GmbH
图源:ERS electronic GmbH
华芯智能致力成为全球优质的一站式半导体晶圆级封测分选检测和平板级封装贴晶机方案供应商。其大尺寸板级封装贴片机,应用于Panel板级封装,已经实现高精度(±10um)、高UPH(20k)、大尺寸Panel板(最大可达800mmx800mm),应用于扇出器件的贴片工艺,目前已量产出货到国内一线厂家。
深科达正在向半导体封测等领域延伸业务。公司研发生产的板级封装固晶机主要适用于ESD、MOS以及第三代半导体SIC、GAN器件,该设备目标位置精度≤±10微米,角度精度≤±0.2,平板尺寸:685x650mm,效率:UPH≥5K/H。
 全自动激光解键合设备 图源:大族半导体
全自动激光解键合设备 图源:大族半导体
大族半导体致力于成为半导体装备制造领域标杆企业,其全自动激光解键合设备可为面板级先进封装制程(比如扇出型、TSV 2.5D/3D集成)以及SiC、GaN等超薄器件制备流程中临时键合工艺提供整套解键合及清洗解决方案,设备可应对4、6、8、12inch全尺寸;wafer、frame全系列产品,支持AGV/OHT自动化生产。
华海诚科主要产品为环氧塑封料和电子胶黏剂在先进封装领域,在FOPLP等先进封装领域的相关产品正逐步通过客户的考核验证,有望逐步实现产业化,进一步推动封装材料国产化替代。
礼鼎半导体主营业务为高阶导体封装载板,公司正积极布局高阶面板级扇出型封装。2023年1月鹏鼎控股拟以1.36亿美元投资礼鼎半导体。2023年5月公司完成A+轮融资。
思沃先进是业内率先为先进封装PLP板级封装环节导入真空增层设备的企业。公司“FOPLP微增层真空贴膜系统”成功进入量产,以应对PLP在高温/高压/高真空度复杂物理环境中整平精度(0.003mm,CPK>1.33以上)的挑战。